晶圆,始于薄的圆柱型晶硅,直径一般分150毫米(6英寸)、200毫米(8英寸)、300毫米(12英寸),通过在晶圆上镀上各种材料成为多层膜和几何图形,最终产生出成千上万很小的电子器件。
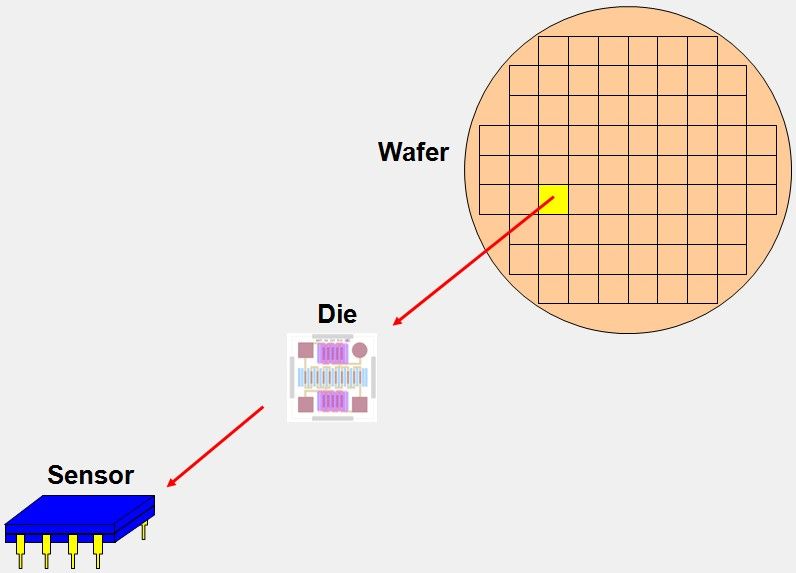
晶圆的制造过程可划分为前道(Front-end)和后道(Back-end),前道包括晶圆处理工序(Wafer Fabrication)和晶圆针测工序(Wafer Probe),后道包括封装工序(Packaging)和测试工序(Initial Test and Final Test)。晶圆的整个制造过程中会涉及到很多物理、化学过程。
一、前道(Front-end)
1、晶圆处理工序Wafer Fabrication
本工序的主要工作是在晶圆上制作磁路和电路,其处理程序的基本步骤是先将晶圆适当清洗,再在其表面进行氧化和物理/化学气相沉积,然后进行镀膜、光刻、刻蚀、回火等反复步骤,最终在晶圆上完成磁性传感器芯片的加工与制作。

晶圆处理工序
工艺过程注释:
【光刻 Lithography】: 光刻的过程包括涂胶、曝光和显影。涂胶是在基片表面均匀涂上一层光刻胶。光刻胶主要由对光与能量非常敏感的感光高分子聚合物和有机溶剂(稀释剂)组成,前者是光刻胶的主体,主要成分为脂肪质酰亚胺聚合物、聚酰胺等,后者是光刻胶的介质,主要成分为环戊酮,丙二醇单甲醚等。为使光刻胶牢固附着在基片表面,均匀涂胶后要进行烘干。在烘干过程当中,光刻胶中的有机溶剂挥发成为有机废气,而光刻胶中的高分子聚合物和光敏剂等作为涂层牢固地附着在基片表面。光刻胶对紫外光敏感,被光照过后发生化学变化,从而变得容易被显影液去除,而没有被光照过的光刻胶则不会在显影工序中去掉。曝光就是利用光刻胶的这种特性,使用光刻机将事先设计好的电路通过掩膜版将电路图案转移到基片表面。显影是用显影液将感光的光刻胶去除,在光刻胶上形成沟槽,使下面的基片表面暴露出来,以便于下一道工序进行操作。
【离子刻蚀Ion Milling】: 离子刻蚀是用离子轰击的方法去除基片表面所不需要部分的工艺。其具体流程为刻蚀气体通入反应室(通常为氩气),在反应室两端高电压作用下,电场将氩气分解电离,形成正的氩离子和负的电子。正的氩离子在电场的作用下向放置有基片的负极移动,在移动过程中不断加速,最终轰击在基片的表面上,将基片表面的原子吸附并带走,最终实现基片表面材料刻蚀这一步骤。

离子碰撞过程示意图
【感应耦合等离子刻蚀(干法)RIE (Reactive Ion Etching)/ICP (Inductively coupled plasma)】: 反应离子刻蚀(RIE)是在等离子氛围中通入反应气体,对基片进行选择性腐蚀的过程,项目刻蚀气体使用的有三氯化硼,氯气,三氟甲烷,六氟化硫等。其反应原理如下:(1)CHF3 + e —> CHF2 + F(自由基) + e(2)F + SiO2 —> SiF4↑ + O2↑ 用于刻蚀SiO2 (3)F + Si4N3– -> SiF4↑ + N2↑ 用于刻蚀氮化硅 (4) Cl + Si —> SiCl4↑ 用于刻蚀硅。 在反应离子刻蚀中,主要起作用的是电离后的氯、氟等离子。感应耦合等离子体刻蚀ICP(Inductively coupled plasma)与RIE不同的是,反应腔室外额外附加螺线圈,使线圈产生感应耦合的电 场,在电场作用下,刻蚀气体辉光放电产生高密度等离子体。能产生比RIE高一个数量级的离子浓度,从而提高了刻蚀速率,而且降低了DC bias损伤。
【湿法(R / S,湿蚀刻) Wet Process (R / S, Wet Etch)】: 湿法工艺包括湿法的各项同性刻蚀和光刻胶剥离。
【退火Anneal】:磁场退火,也叫磁场热处理,即在对材料热处理的过程中加入磁场。对于软磁材料来说,磁场热处理对软磁合金的作用可以简单的看作是给材料附加了一个单轴各向异性,又称磁感生各向异性,这个各向异性的大小和方向可以人为的控制,调制材料的磁滞回线,从而使处理后的材料满足某些特定的需要。磁场热处理过程中,处理温度足够高时,材料中的原子开始运动(扩散),并使自身磁矩相对于磁化方向取向,这样可以使他们的磁各项异性能最小,一旦冷却到原子不再扩散的温度时去掉外磁场,原子对方向有序化将被冻结,并且保持磁化退火时的取向形成感生磁各向异性。
【等离子体增强化学气相沉积(Plasma Enhanced-CVD)】:化学镀膜(CVD)是利用化学反应的方式进行镀膜的方法。反应气体和携带气体(氮气)不断通过反应室,通过一定的化学反应生成所期望的薄膜。而等离子体增强化学气相沉积(Plasma Enhanced-CVD) 作为化学镀膜方法的一种,利用辉光放电等离子体的影响来生长薄膜,可以在低温下达到理想的沉积速率,降低反应温度达600℃ 以下,典型温度300-350℃, 避免一般CVD高温的引起:1.基板变形和组织结构变化;2.基板材料与膜层互扩散等问题。沉积氮化硅和氧化硅的一般反应如下:(1)3SiH4 + 4NH3 —> Si3N4 ↓+ 12H2↑ (2)SiH4 + 2N2O —> SiO2↓+2N2↑ + 2H2↑
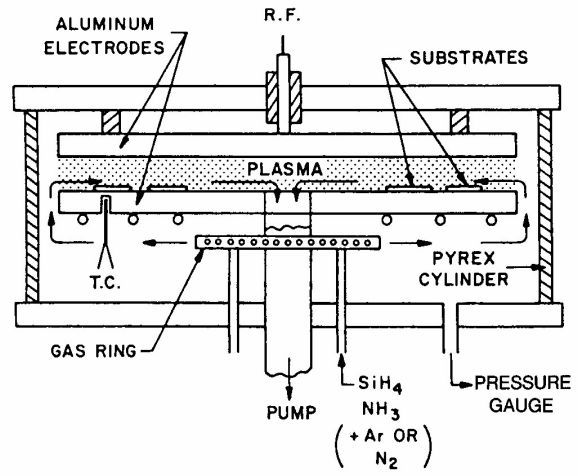
【物理气相沉积(PVD-Sputter (DC / RF, Magnetron, IBD…))】: 真空溅射镀膜是一种用物理轰击的方法产生薄膜的技术,其方法是:将欲沉积的材料制成靶材,固定在阴极上,基片置于正对靶面的阳极上,设备抽真空至一定程度后充入一定量的氩气,在阴极和阳极之间加几千伏的高压,两极间即产生辉光放电。放电产生的高能粒子在电场的作用下轰击靶材表面,使靶材固体表面的粒子获得能量并逸出表面,沉积在基片上。其既可以沉积金属导电膜,也可以沉积非金属的绝缘膜。在溅射镀膜的几种方法中,直流溅射(DC sputter)适用于金属材料,射频溅射(RF sputter)适用于各种金属和非金属材料。而磁控溅射(Magnetron sputter)则是在溅射装置中的靶材附近加入磁场,垂直方向分布的磁力线将电子约束在靶材表面附近,延长其在等离子体中的运动轨迹,增加电子运动的路径,提高电子与气体分子的碰撞几率和电离过程。相比之下,在同样的电流和气压条件下可提高沉积速率,并提高了薄膜的均匀度。离子镀膜(ion beam deposition – IBD)是溅射镀膜的另一种方式,它将离子源与工作腔隔绝开来,可避免普通溅射镀膜方式带来的(氩)离子污染。


2、晶圆针测工序Wafer Probe
经过晶圆处理工序后,晶圆上即形成许多小格,称之为晶方或晶粒(Die)。在一般情形下,同一片晶圆上皆制作相同的晶片,但是也有可能在同一片晶圆上制作不同规格的产品;这些晶圆必须通过晶片允收测试,晶粒将会逐一经过针测(Probe)仪器以测试其电气特性,不合格的晶粒将会被标上记号(Ink Dot),此程序称为晶圆针测工序(Wafer Probe)。然后晶圆将依晶粒为单位被切割成一粒粒独立的晶粒。
二、后道(Back-end)
1、封装工序Packaging
将单个的晶粒固定在塑胶或陶瓷制的芯片基座上,并把晶粒上蚀刻出的一些引接线端与基座底部伸出的插脚连接,以作为与外界电路板连接之用,最后盖上塑胶盖板,用胶水封死。其目的是用以保护晶粒避免受到机械刮伤或高温破坏。到此才算制成了一块集成电路芯片(Integrated Circuit;简称IC)。
封装工序的工艺过程:
(1)晶片切割(die saw) :晶片切割之目的为将前制程加工完成之晶圆上一颗颗之晶粒(die)切割分离。
(2)粘晶(die mount / die bond) :粘晶的目的是将一颗颗晶粒置于导线架上并以银胶(epoxy)黏著固定。粘晶完成后之导线架则经由传输设备送至弹匣(magazine)内,以送至下一制程进行焊线。
(3)焊线(wire bond):封装制程(Packaging)是利用塑胶或陶瓷包装晶粒与配线以成集成电路,此制程的目的是为了制造出所生产的电路的保护层,避免电路受到机械性刮伤或是高温破坏。最后整个集成电路的周围会向外拉出脚架(Pin),称之为打线,作为与外界电路板连接之用。
(4)封胶(mold):封胶之主要目的为防止湿气由外部侵入、以机械方式支持导线、内部产生的热量之去除及提供能够手持之形体。其过程为将导线架置于框架上并预热,再将框架置于压模机上的构装模上,再以树脂充填并待硬化。
(5)剪切/成形(trim / form):剪切之目的为将导线架上封装完成之晶粒独立封开,并把不需要的连接用材料及部份凸出之树脂切除(dejunk)。成形之目的则是将外引脚压成各种预先设计好之形状 ,以便于装置于电路板上使用。剪切与成形主要由一部冲压机配上多套不同制程之模具,加上进料及出料机构所组成。
(6)印字(mark):印字乃将字体印于封装完的塑胶之上,其目的在于注明商品之规格及制造者等信息。
(7)检验(inspection):主要是外观检查。
2、测试工序 Initial Test and Final Test
芯片制造的最后一道工序为测试,其又可分为一般测试和特殊测试,前者是将封装后的芯片置于各种环境下测试其电气特性,如消耗功率、运行速度、耐压度等。经测试后的芯片,依其电气特性划分为不同等级。而特殊测试则是根据客户特殊需求的技术参数,从相近参数规格、品种中拿出部分芯片,做有针对性的专门测试,看是否能满足客户的特殊需求,以决定是否须为客户设计专用芯片。经一般测试合格的产品贴上规格、型号及出厂日期等标识的标签并加以包装后即可出厂,而未通过测试的芯片则视其达到的参数情况定为降级品或废品。
整个芯片制造过程中主要包含的测试 :
(1)芯片测试(wafer sort);
(2)芯片目检(die visual);
(3)芯片粘贴测试(die attach);
(4)压焊强度测试(lead bond strength);
(5)稳定性烘焙(stabilization bake);
(6)温度循环测试(temperature cycle);
(7)离心测试(constant acceleration) ;
(8)渗漏测试(leak test);
(9)高低温电测试(temperature cycling testing);
(10)高温老化(burn-in);
(11)老化后测(post-burn-in electrical test)。






